Jacopo Franco
imec, Belgium
nbti
igzo
reliability
hot-carrier degradation
nand
breakdown
bti
tcad
memory
dram
defect
photodiode
mm-wave
mos-hemt
noise
12
presentations
SHORT BIO
Jacopo Franco is a Principal Member of Technical Staff in the Reliability group of the Advanced Reliability, Robustness and Test department of imec, Belgium. He received the B.Sc. (2005) and M.Sc. (2008) from the University of Calabria - Italy, and the Ph.D. degree from KU Leuven - Belgium (2013) in Electrical Engineering. His research focuses on CMOS FEOL reliability characterization, optimization, and modelling, and in particular: i) on gate stack development for novel device technologies (SiGe, Ge, III-V, IGZO), architectures (finFETs, FD-SOI, Nanowires, Nanosheets), and integration schemes (Sequential 3D tier stacking, CFETs); ii) on characterization and physics-based modelling of FEOL degradation mechanisms (BTI, Hot Carrier, Off-state degradation, TDDB, RTN, time-dependent variability); iii) on reliability compact models to accurately propagate individual device aging to circuit level. He has (co-)authored 250+ contributed or invited papers and 3 patent families, and he is a recipient of several IEEE awards: Best Student Paper at SISC (2009), EDS Ph.D. Student Fellowship (2012), Paul Rappaport Award (2011), Best (2012, 2022), Outstanding (2014), and Best Student (2016) paper awards at IRPS. He has been serving in various functions on the Technical Program Committees of IRPS (Chair of the ‘XT-Transistors’ subcommittee in 2020), SISC, IIRW, ESREF, WoDiM and InFOS conferences, and as an Editor of IEEE Transactions on Device and Materials Reliability (2017-2020) and of IEEE Transactions on Electron Devices (2020-2022).
Presentations

Side and Corner Region Non-Uniformities in Grown SiO2 and Their Implications on Current, Capacitance and Breakdown Characteristics
Joao Bastos and 9 other authors

Exploiting Bias Temperature Instability for Reservoir Computing in Edge Artificial Intelligence Applications
Yuanyang Guo and 7 other authors

Light-assisted investigation of the role of oxygen flow during IGZO deposition on deep subgap states and their evolution under PBTI
Pietro Rinaudo and 10 other authors

SILC and TDDB reliability of novel low thermal budget RMG gate stacks
Andrea Vici and 4 other authors

Fundamental understanding of NBTI degradation mechanism in IGZO channel devices
Ying Zhao and 11 other authors

DC Reliability study of high-k GaN-on-Si MOSHEMTs for mm-Wave Power Amplifiers
Barry O'Sullivan and 10 other authors

Degradation and recovery kinetics study of vertical and lateral Ge-on-Si photodetectors
Solomon Musibau and 7 other authors

Observation of Significant Enhancement of HCD and TDDB in CMOS FETs by Mechanical Stress
Kookjin Lee and 9 other authors
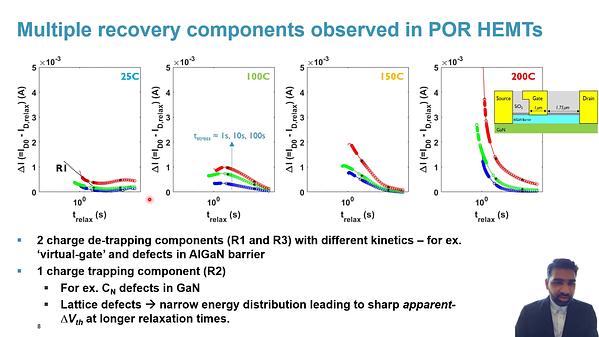
Interpretation and modelling of dynamic-RON kinetics in GaN-on-Si HEMTs for mmWave applications
Vamsi Putcha and 7 other authors

BTI of High-Voltage Logic-for-Memory Devices
Joao Bastos and 14 other authors

Evaluating Forksheet FET reliability concerns by experimental comparison with co-integrated Nanosheets
Erik Bury and 8 other authors
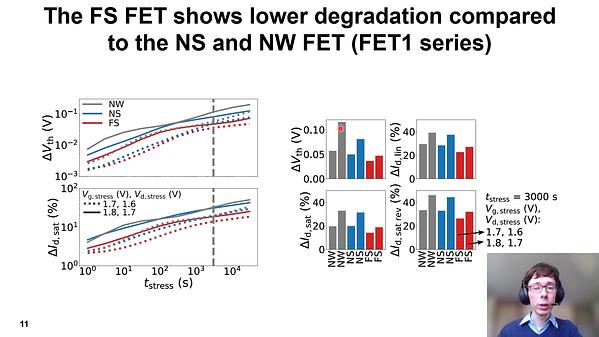
Simulation Comparison of Hot-Carrier Degradation in Nanowire, Nanosheet and Forksheet FETs
Michiel Vandemaele and 7 other authors